SoC是采用IP复用技术的一种标准设计结构,在多功能电子产品中得到了广泛的应用。SoC的典型结构包括CPU、存储器、外围逻辑电路、多媒体数字信号编解码器和接口模块等。现在的SoC中,存储器通常占据整个芯片的大部分面积,并且可能包括各种类型的嵌入式存储器,如DRAM、SRAM及Flash存储器等,可满足不同的应用需要。目前SoC设计要求存储器的容量不断地增大,嵌入式存储器在SoC中所占的面积百分比也随之不断增加。另外,SoC的复杂度不断地提高而集成电路工艺尺寸在不断减小,这就导致嵌入式存储器的制造缺陷比例也不断地增加。因此嵌入式存储器的故障率对于SoC的总成品率的影响越来越大,而保证低故障率的关键是高效率和高故障覆盖率的嵌入式存储器测试方案。
在我国,集成电路测试及可测性设计,特别是存储器的测试研究相对国际上的研究比较落后。目前,我国自主研究的测试算法以及开发的测试设备还没有形成产业化,还不能与国际上先进的集成电路测试设备相抗衡。而近几年来,我国在集成电路领域加大了投入,集成电路产业也得到了长足的进步。& s1 q% D* Z' E
集成电路测试也是一个知识密集型的高投入领域,一直是我国集成电路产业发展的制约因素。半导体工业成本发展的特点就是它的单位功能制造成本以每年平均25%~30%的比例下降,而测试成本却以每年平均10.5%的比例提高。随着集成电路复杂度的不断提高,为其设计的测试电路也越来越复杂,测试电路占用的芯片面积及设计制造成本也变得更高。
8 ?6 h+ u7 l+ K' [0 f
本文对嵌入式存储器的测试及可测性设计进行研究总结,为我国存储器测试的研究以及集成电路测试产业的发展奠定坚实的技术基础。
' u4 B7 `/ J, N
嵌入式存储器测试方法
半导体存储器自20世纪60年代开始设计生产以来,在设计结构、产品的性能和存储的密度等各方面发生了巨大的变化,现在嵌入式存储器技术的发展已经取得了很大的成就,并被广泛应用于各类基于SoC芯片设计的电子产品中,已经成为大多数电子系统中必不可少的组成部分,在人们的生产生活中起到了举足轻重的作用。嵌入式存储器的测试方法主要包括以下三类:
存储器直接存取测试
0 U$ Z# C7 d: \: p
此类测试方法把嵌入式存储器部分从整个系统中分离出来,由专用的存储器测试电路连接到存储器接口上对嵌入式存储器进行测试,系统框图如图1所示。' E9 q5 V2 ~" O |
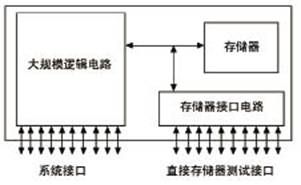 0 T8 b4 h3 a$ R. v8 p
0 T8 b4 h3 a$ R. v8 p图1 存储器直接存取测试